◆
電漿輔助化學氣相沉積絕緣層 :
機台: ASM PECVD
製程:Low stress Nitride, Oxide
• Substrate size: 6”.
• Uniformity < ± 10%
• Capacity: 10k pieces/month
|
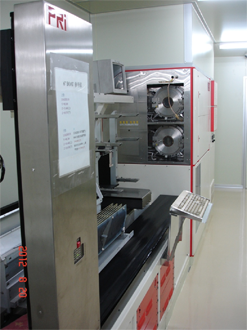 |
◆
電漿輔助化學氣相沉積絕緣層 :
機台: AMAT PECVD: PE Nitride, TEOS Oxide
製程:PE Nitride, TEOS Oxide
• Substrate size: 6”.
• High uniformity SiN and oxide was achieved.
• Uniformity < ± 2% (@Thickness 20nm)
• Capacity: 10k pieces/month
|
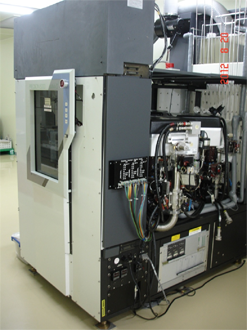 |
◆
低壓化學氣相沉積絕緣層 :
機台: TEL LPCVD
製程:Nitride, low stress SiN
• Substrate size: 6”.
• High uniformity SiN was achieved.
• Uniformity < ± 5% (@Thickness 20nm)
• Capacity: 10k pieces/month
|
|
◆
常壓氧化爐管 :
機台: 弗侖斯氧化爐管
製程:Dry thermal oxide
• Substrate size: 6”.
• Uniformity < ± 5% (@Thickness 20nm)
• �� Capacity: 10k pieces/month
|
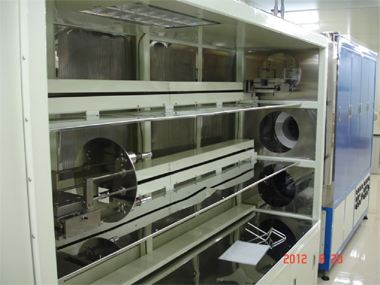 |
◆
低壓燒結熱處理爐 :
機台: 弗侖斯低壓燒結熱處理爐
製程:P.I., BCB curing
• AFS vacuum furnace for ILD curing
• Temperature: 100 ~450 degree C
• Vacuum : 5 x 10-5 torr
• Gas: N2
• Capacity: 10k pieces/month
|
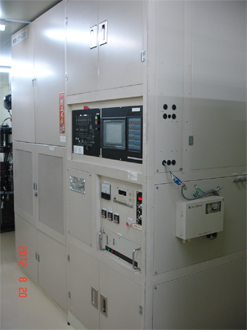 |
◆
離子濺鍍沉積薄膜 :
機台: CVC sputter systems
製程:TaN 、TiW、Ta2O5、Ta、NiCr
•Substrate size: 6".
•Pre-sputter of RF back etching capability.
•Reactive sputter capability.
•Substrate Heating (up to 300℃) capability.
•Continue multi layer process capability.
•Uniformity < ± 5% (@Thickness 20nm)
•Capacity: 10k pieces/month
|
 |
◆
離子濺鍍沉積薄膜 :
機台: MRC643 Vertical sputter systems
製程:CrSi、AL濺鍍
• Substrate size: 6".
• Pre-sputter of RF back etching capability.
•Continue multi layer process capability.
• Uniformity < ± 7%
• Capacity: 10k pieces/month
|
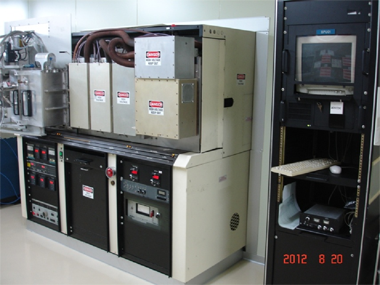 |
◆
離子濺鍍沉積薄膜 :
機台: Fulintec Vertical sputter systems
製程:Ti、Cu濺鍍
•Substrate size: 6" or 8".
•Pre-sputter of RF back etching capability.
•Continue multi layer process capability.
•Uniformity < ± 10%
•Capacity: 30k pieces/month
|
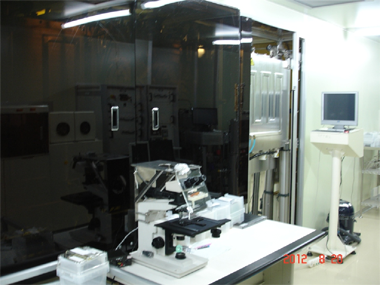 |
◆
電子束蒸鍍薄膜 :
機台:CHA e-beam deposition systems.
製程:Ti、Cu、Ni、Au連續蒸鍍
• Substrate size: 6"
• Vacuum: 5 x10-7 torr
• Continue multi layer process capability.
• Uniformity < ± 10%
• Capacity: 3k pieces/month
|
 |